AI外観検査装置 nSpec®

独自開発のAIと装置本体を完全に一体化
・米国Nanotronics社が開発・製造、国内ではアミリアジャパンがデモからサポートまで全てカバー。
・ルールベースの外観検査装置ではレシピ作成に時間を要する課題を解決、高精度・高速な検査を実現。
・独自開発AIと最適化した光学系で欠陥の正確な検出・分類と原因分析により、製品開発やプロセス改善に有効。
・SiCやGaNなどの化合物ウェハやエピ特有の曖昧な欠陥、パターン欠陥をウェハ全面で検出・分類。





・米国Nanotronics社が開発・製造、国内ではアミリアジャパンがデモからサポートまで全てカバー。
・ルールベースの外観検査装置ではレシピ作成に時間を要する課題を解決、高精度・高速な検査を実現。
・独自開発AIと最適化した光学系で欠陥の正確な検出・分類と原因分析により、製品開発やプロセス改善に有効。
・SiCやGaNなどの化合物ウェハやエピ特有の曖昧な欠陥、パターン欠陥をウェハ全面で検出・分類。




AIを利用した検査では、明るさ以外にも色や形など様々な特徴を学習させ、それをグループ化することにより人の感覚に近い検査を行うことができ、検出と同時に分類も可能となります。
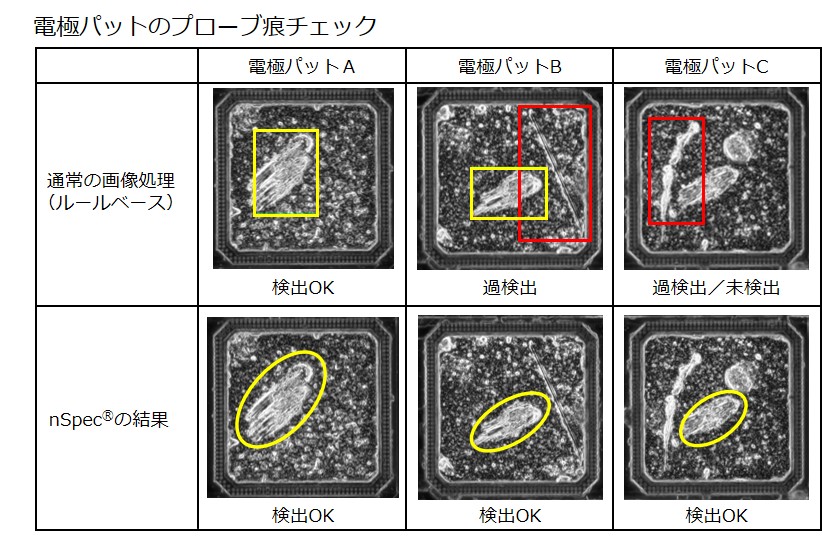
AI検査であれば狙った異物・欠陥だけをみつけることができます。
検査と同時に分類分けを行うことで、デバイスを製造する上で不良の要因となるキラー欠陥・異物を早期に発見することも可能になります。
・開発期間の短縮 ・製造の早期立ち上げ ・品質の向上
製造シーンのあらゆる工程に寄与することが可能です。

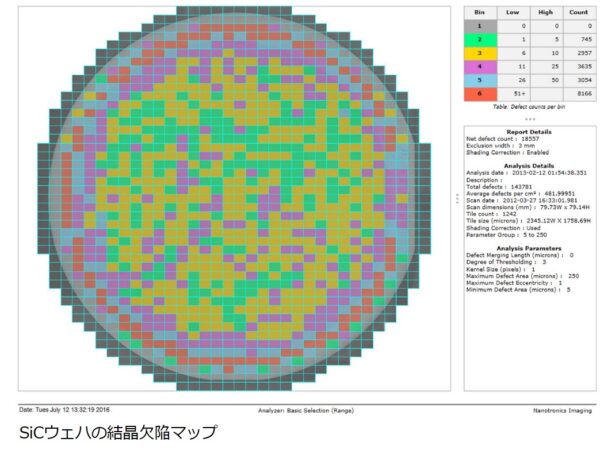
gOD機能は検出した異物・欠陥が製造工程間でどのように変化していったかを追従することを可能としたソフトウェアです。
各工程の検査結果を入力して歩留まりをモニタリングする機能により、影響を与える異物・欠陥の早期特定が出来ます。
ニーズに応じてカスタマイズ対応も可能です。
gODの活用例
欠陥A→ベアウェハの状態から存在しているが最終検査工程でも異常とならなかったのであっても問題ない欠陥と判断できる。
異物B→エピ後に発生したものであるが、パターン形成工程でパターン不良を起こす原因となっているので除外する必要がある。
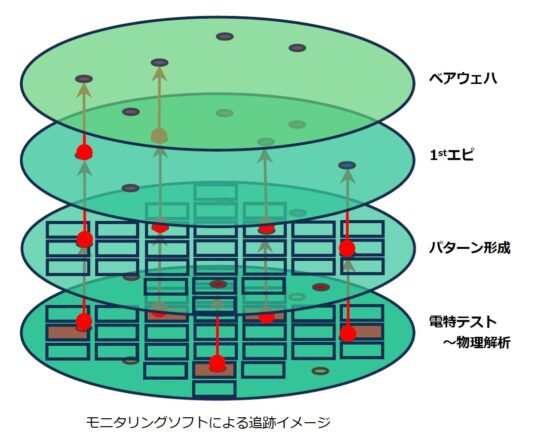
自動的に良品テンプレート画像を生成する機能です。生成に使用する画像に異常個所があったとしても、画像上の同一箇所に存在していなければ無視をして良品テンプレートを生成可能です。
テンプレート生成後は元画像と差分比較することで異常個所の検出まで行います。
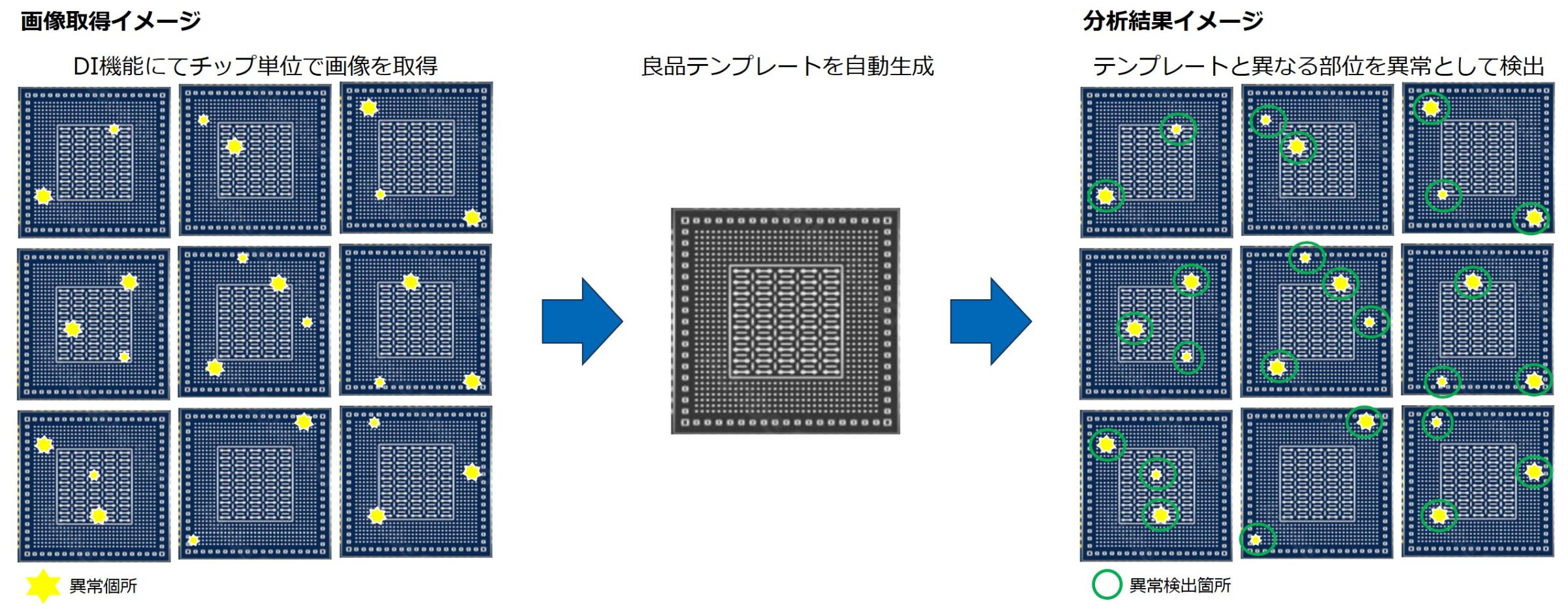
自動抽出した特徴画像を切り出しリスト化し見やすくします。そして、見本を参考に対象の特徴であるか判断し、合致した場合はその名称をリストから選択し登録します。最後は画像単位で見比べ検証します。検証後は付属のAI学習ソフト用にデータ変換されます。

 SiCウェハ(マイクロパイプ) |
 金パットのシミ |
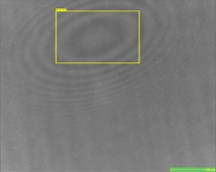 干渉縞 |